芯片制造的过程有8步,最后一步是芯片出厂的最关键一步——测试和包装,芯片生产已经全部完成,去除不良品,并包装发布。测试芯片过关,需要得到芯片的可靠性验证,可靠性验证测试有:HTOL,HAST,HTSL,TC等测试。
我们今天先来说说前2种验证测试,HTOL/HAST测试。
HTOL测试中文全称”芯片加速老化测试”,目的是为了确定长时间的电气偏差和温度对器件的影响,评估器件在超热和超电压情况下一段时间的耐久力,也就是在正常工作的寿命期间潜在的固有故障被加速,这样就可以在相对比较短的时间内模拟出产品的正常使用寿命。
HTOL测试需要高温工作寿命的测试条件遵循JESD22-A108进行,除了给器件合适的偏置与负载外,主要包括温度应力和电压应力,这两者都属于加速因子。合理设置温度应力和电压应力,以便在合理的时间和成本下完成寿命评估。
HAST测试中文全称“加速老化测试”,是为了提高环境应力(如:温度)与工作应力(施加给产品的电压,负荷等),加快试验过程,缩短产品或系统的寿命试验时间,因此用来确定成品质量时间也相应增加了许多为了提高试验效率,减少试验时间。
HAST测试需要高度加速的温度和湿度应力测试 (HAST) 加速了与 85°C/85% 相对湿度测试相同的失效机制。典型的测试条件是 130°C/85% 相对湿度、加压和非冷凝。该测试加速水分通过外部保护材料(封装或密封)或沿着外部保护材料和金属导体之间的界面渗透,金属导体通过它。在高度加速的温度和湿度应力测试之前,对表面贴装器件的样品进行预处理和最终电气测试。
深圳凯智通为HAST/HTOL测试制作了HAST/HTOL系列测试老化座,采用开模Socket+探针的结构,精度高测试稳定,同时大大降低设计,降低使用费用,外带散热片解决高功率元器散热问题,安装方便,无需焊接,有两种结构对应不同应用场景:
Open-top 结构适用于自动化设备取放芯片,能够提高大批量芯片老化效率:
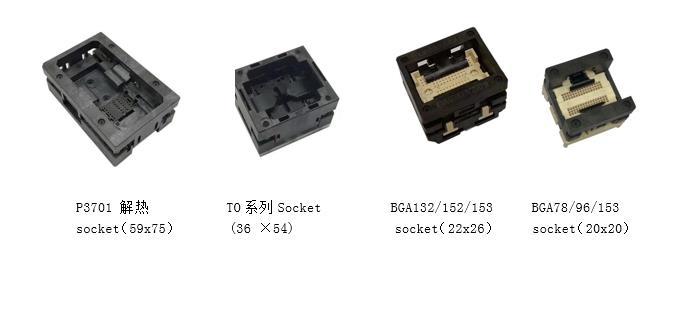
手动翻盖结构适用于手动操作,便于小批量芯片老化:

采用探针接触,针对不同封装芯片选用对应探针,接触温度可靠
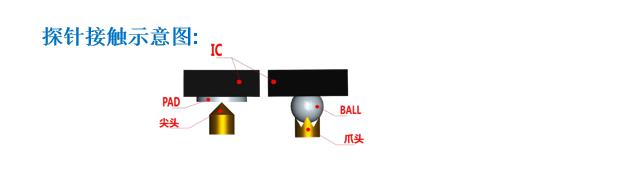
产品数据:
1、材料:PEI/PPS/PeeK
2、适用IC尺寸:1.5x1.5~37x37mm
3、最高频率:>9.3GHZ
4、结构:Open-top/翻盖
5、接触方式:探针/弹片
6、工作温度:-55℃~175℃
产品特点:
1、采用开模Socket+探针的结构,大大降低设计、加工成本,降低了使用费用
2、根据实际测试情况,选用不同探针,可以对IC进行有锡球、无锡球不同测试
3、交期快,最快1天交货,提高使用效率
4、进口探针配合高精度模具,Socket测试更稳定
工厂地址:深圳市宝安区福永镇稔田工业南路14号
定制热线:18188646150




































 1342
1342